分享:Sn/Cu互连体系界面和金属间化合物层Kirkendall空洞演化和生长动力学的晶体相场法模拟
华南理工大学材料科学与工程学院, 广州 510640
摘要
采用二元合金晶体相场模型模拟研究了Sn/Cu互连体系Cu/Cu3Sn界面及金属间化合物层中Kirkendall空洞形成和形貌演化及长大过程, 对Kirkendall空洞生长的微观机制进行了剖析, 同时还模拟和分析了界面Cu3Sn层厚度和杂质含量对Kirkendall空洞形貌和生长动力学的影响. 研究表明, Kirkendall空洞的生长过程由4个阶段组成: Cu/Cu3Sn界面形成大量原子错配区, 原子错配区迅速成长为空洞, 空洞的长大及随后的空洞合并生长. Kirkendall空洞优先在Cu/Cu3Sn界面处形核, 其尺寸随时效时间的延长而增大, 并在时效后期空洞的生长伴随有空洞的合并. Cu3Sn层厚度增加和杂质含量增多均使得Kirkendall空洞数量和生长指数增加以及尺寸增大, 并且2种情况下空洞数量随时间的变化均呈现先增后减的规律.
关键词:
近年来电子产品不断向微型化、多功能化和高可靠性发展, 要求芯片与元器件的封装密度愈来愈高、互连间距和焊点尺寸愈来愈小[1,2]. 随着互连焊点尺寸的日益减小而服役条件的不断复杂和严酷(如承受电流、热流和应力等的耦合作用), 对微焊点电学和力学等性能的要求亦越来越高[2]. 互连尺寸不断减小导致焊点形成过程中反应界面层在整个接头中的体积分数不断增大, 而界面微观组织对接头可靠性的影响非常大. 微互连界面微观组织主要指焊点形成过程中钎料中Sn元素等与金属基底或凸点下金属层(under bump metallization, UBM)元素等发生界面冶金反应而生成金属间化合物(intermetallic compound, IMC). 焊点界面形成的IMC层是焊接界面获得冶金结合的标志, 同时其也是互连焊点中的薄弱部分[3]. 适当厚度的IMC层可以提高钎料润湿能力并改善接头的性能; 但在回流焊过程中, IMC层的过度生长会造成其颗粒数量过多和分布不均匀, 甚至出现Kirkendall空洞(或称为孔洞而与空洞混用, 本工作称之为空洞)等微观缺陷; 而当焊点在较高工作温度下服役时(相当于固态时效过程), 接头界面区域也会出现Kirkendall空洞并且其尺寸随温度的升高和时间的延长而增大; 后期空洞还会出现合并生长, 造成焊点承载和导电面积的减小, 严重时还能成为脆性断裂源, 进而危害焊点可靠性和热疲劳寿命[4,5]. 不同钎料合金与基底金属形成的IMC类型、成分、形貌及形核点均不同, 使得Kirkendall空洞出现不同的形貌演化过程和生长行为, 导致焊点服役寿命和失效方式的不同[6,7]. 由于Kirkendall空洞对微焊点力学性能和电互连性能有很大影响, 其存在使微互连的可靠性和寿命均受到严峻的挑战, 进而影响电子产品的微型化进程; 目前, 焊点中的Kirkendall空洞问题正成为理论和实验研究的热点之一. 因此, 阐明Kirkendall空洞在不同条件下的形貌演化和生长规律, 掌握影响Kirkendall空洞形成和长大的材料、工艺和服役条件等因素, 对电子封装微焊点可靠性的评估非常重要, 这方面的研究具有重要理论意义和工程应用价值.
微焊点IMC层及Cu/Cu3Sn界面层中Kirkendall空洞的形成过程较为复杂, 包括孕育、形核、生长和聚合4个阶段[8]. 对于Sn/Cu互连体系, Cu原子以较快迁移率向钎料方向扩散后在裸Cu侧所留下的位置未能完全被Sn原子填充, 便产生了原子级别的空缺; 这些空缺在Cu/Cu3Sn界面和Cu3Sn层内聚集起来导致了Kirkendall空洞的产生, 并在后续工艺(如多次回流焊)或服役过程发生长大. 此外, 实际焊点中由于温升而造成IMC层之间或者IMC层与钎料和基底金属之间热膨胀的差异, 导致Kirkendall空洞处出现应力集中, 进而促使空洞发展成裂纹源, 并最终导致焊点发生脆性断裂. 因此, Kirkendall空洞的形成对微焊点可靠性的影响较大.
目前已有一些关于Kirkendall空洞形成、生长形貌及生长动力学的初步研究. Ahat等[9]研究了62Sn-36Pb-2Ag和96.5Sn-3.5Ag钎料与Cu基底组成的焊点在150 ℃不同时间(50~1000 h)的时效情况, 发现Kirkendall空洞在Cu3Sn层中形成和长大并影响焊点的剪切强度. Lin和Luo[10]研究发现, 焊点中的Kirkendall空洞密度随焊点时效时间和时效温度的增加而增大, 且空洞的形成是造成焊点强度和可靠性降低的主要因素. Zeng等[11]研究表明, 共晶Sn-Pb钎料与电镀Cu焊盘反应之后焊点Cu/Cu3Sn界面上Kirkendall空洞数量随时效时间的延长而增加, 同时Cu3Sn层中Kirkendall空洞数量也在不断增加. Wang等[12]研究了不同IMC层厚度对Kirkendall空洞生长行为的影响, 发现空洞数量随IMC层特别是Cu3Sn层厚度的减小而减少. 目前, 工程中在控制Kirkendall空洞方面主要是通过适当的工艺抑制其出现, 如通过改变电镀参数[13-15]来减少杂质的引入量(含量), 以抑制Kirkendall空洞形核; 对电镀Cu基底进行高温退火处理[16], 通过消除镀层中的异质相进而抑制Kirkendall空洞的形核和长大. 虽有不少实验工作研究了Kirkendall空洞问题, 但通过实验手段获取Kirkendall空洞形貌演化和生长行为的过程耗时又耗力, 获得的信息也非常有限, 难以揭示Kirkendall空洞完整的形成过程和生长行为. 显然, 若能从材料的微观结构(杂质含量、IMC层厚度等)及空洞形核机制等入手, 采用理论分析和数值模拟的方法再现微焊点中Kirkendall空洞的微观形貌和动力学演化行为, 并与实验互为补充和印证, 将有助于全面而深入地掌握微焊点中的Kirkendall空洞形成过程及其生长规律. 在已有的模拟研究中, 主要是针对Kirkendall空洞形成过程中的空位形成能和扩散能, 采用第一原理的方法进行研究. 研究采用基于密度泛函理论的平面波赝势方法(plane wave pseudopotential, PWP)[17]和拟Newton算法(quasi-Newton methods)[18], 通过广义梯度近似(general gradient approximation, GGA)[19]结合超软赝势(ultra soft pseudo potential, USPP)[20]来处理关联项; 但是运用第一原理获得的研究结果不能直观形象地再现Kirkendall空洞的形貌. 近年来发展起来的晶体相场(phase field crystal, PFC)法在解决晶体材料原子尺度作用方面有不可替代的优势; 因其能够在原子尺度上模拟材料的微观结构演化, 同时可以耦合晶体点阵周期结构, 所以在研究晶体点阵缺陷包括空位及由空位聚集而形成Kirkendall空洞等方面有巨大的优势.
本工作采用PFC法模拟研究Sn/Cu互连体系(微焊点)中的Kirkendall空洞形貌演化和生长动力学行为, 阐明焊点界面IMC层厚度和杂质含量对Kirkendall空洞形貌和生长的影响机制. 模拟研究旨在揭示微焊点界面Kirkendall空洞微观形貌演化规律的同时提供必要的生长动力学信息, 以期全面而深入地掌握Kirkendall空洞形貌演化和生长行为的量化规律, 并对优化相关实验研究提供理论支持; 采用计算模拟不仅有助于进一步研究Kirkendall空洞对焊点可靠性的影响, 同时对深入了解Kirkendall空洞形成过程有着十分重要的意义.
1 相场模型的建立
目前应用的无铅钎料主要是高Sn含量(>95%)二元或三元合金, 基底金属(UBM)主要为Cu, 故模拟时可用Sn/Cu体系代替实际的微互连体系. 目前研究的Kirkendall空洞主要存在于Sn/Cu互连体系的Cu3Sn层和Cu/Cu3Sn界面[10,11]. 本研究选择Sn/Cu体系中IMC层和Cu基底; 由于Kirkendall空洞多分布于Cu3Sn层, 故模拟区域仅限于Cu3Sn层, 暂不考虑无空洞分布的Cu6Sn5层; 此外, 模型不考虑Cu和Cu3Sn相组成晶粒的取向差异性, 故整个模拟区域内包含2个独立的固相区(即Cu3Sn层和Cu基底层)和界面层, 如图1所示.
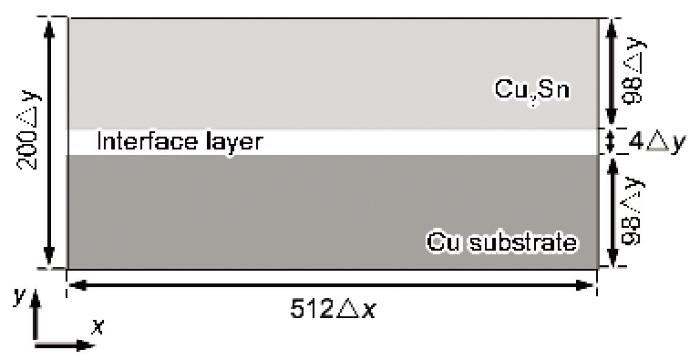
图1 模拟计算采用的二维区域示意图
对于由Cu和Sn 2种原子组成的二元合金, 构造的关联函数最低阶的自由能泛函为[21]:
其中, F为自由能泛函, r1和r2为位置相关函数,
为建立合金自由能和标准相场模型之间的关联, 通常定义总的密度函数
式中,
通常选取各原子的原子密度求解动力学方程(2), 引入Cu和Sn组元原子的无量纲密度函数nCu和nSn:
同时引入如下密度场和浓度场进行扩展计算:
以下的计算中采用
其中,
其中,
在Kirkendall空洞的模拟中, 常采用无量纲原子密度来更为方便地表示动力学方程, 即采用
其中,
动力学方程式(15)和(16)中密度场n的二维单模近似解如下:
其中,
二元合金体系界面空位随着演化时间的增加, 最终形成Kirkendall空洞. 空洞形成初期, 界面形成原子错配区的过程可近似认为是晶界预熔化过程[23]. 在该过程中, 小角度界面取向差可以提供单个不连续的空位列, 大角度界面取向差则提供一列连续的空位线, 在后续的长大过程中逐渐生长成为空洞. 本模拟中结合Sn/Cu合金体系空洞形成过程, 采用小角度界面取向差作为研究对象. 根据已有研究, 在合金无限趋近熔化临界温度时, 润湿温度和界面取向差角度q之间的关系可表述为[24,25]:
其中,
模拟区域上下边界采用Neumann条件, 左右边界采用周期性条件, 对二维体系采用正方形网格划分(
表1 Sn/Cu互连体系模拟所采用的材料属性参数[22]
Table 1 Material parameters used in the simulation of Sn/Cu soldering system [22]
| Symbol | Value | Symbol | Value |
|---|---|---|---|
|
|
0.7 |
|
0.6 |
|
|
-1.8 |
|
1.0 |
|
|
1 |
|
4.0 |
|
|
-0.2571 |
|
1.0 |
|
|
0.2 |
|
4.0 |
|
|
-0.2 |
|
-0.1503 |
2 结果与分析
2.1 Kirkendall空洞的形貌演化
根据图1设定的模拟体系, 初始状态Cu层尺寸范围为
图2为Sn/Cu互连体系Cu/Cu3Sn界面和Cu3Sn层中Kirkendall空洞形貌演化过程的二维模拟结果及与实验结果的对比. 可以看出, 模拟结果显示出Cu/Cu3Sn界面处和Cu3Sn层内分布着大量形状各异、尺寸不均匀的Kirkendall空洞(图2c), 揭示的Kirkendall空洞演化过程如下: (1) 体系达到平衡之后, Cu3Sn层内随机分布着大量原子错配区, 并铺满整个Cu/Cu3Sn界面(图2a); (2) 随时效时间延长, Cu/Cu3Sn界面处原子错配区迅速生长成为Kirkendall空洞; 且界面处空洞迅速长大并发生合并生长, 造成Cu/Cu3Sn界面处空洞呈不规则状(图2b); 随后界面处Kirkedall空洞继续长大, 在Cu3Sn层内大量原子错配区生成尺寸不均匀的Kirkendall空洞并迅速长大, 但由于分布不均且相邻空洞间距较大, 空洞合并生长现象不明显(图2c); (3) 随时效时间进一步延长, 空洞不断合并长大而在Cu3Sn层内和Cu/Cu3Sn界面处均形成尺寸较大且形状不规则的Kirkendall空洞; 同时空洞的数量随合并生长的进行而减少, 空洞尺寸则增大(图2d). 与图2e和f所示Sn-3.0Ag-0.5Cu/Cu焊点在217 ℃等温时效120和240 min后的界面显微组织[3]比较可见, 模拟过程能很好地再现Cu/Cu3Sn界面和Cu3Sn层内Kirkendall空洞的组织形貌, 模拟结果和实验观察的主要特征较为符合. 需要指出, 本研究所采用的晶体相场模型还无法处理Cu/Cu3Sn界面反应过程, 因此模拟结果不能再现Cu/Cu3Sn界面的动态演化过程.

图2 Cu/Cu3Sn界面和Cu3Sn层Kirkendall空洞的模拟结果和组织形貌
Fig.2 Simulated morphologies of Kirkendall voids at the Cu/Cu3Sn interface and in the Cu3Sn layer at different time steps of t=0.1×105 (a), 3×105 (b), 5×105 (c), 7×105 (d) and the experimental observation of Kirkendall voids [3] in the Sn-3.0Ag-0.5Cu/Cu joint aged at 217 ℃ for 120 min (e) and 240 min (f)
随时效温度的改变, Cu和Sn原子迁移率发生相应的改变. 模拟时还设置了不同的Sn原子迁移率(即MSn=0.05, 0.01和0.005)以探讨不同Cu/Sn原子迁移率比值对Kirkendall空洞形貌的影响, 模拟结果如图3所示. 随Sn原子迁移率的减小, 空洞由垂直于界面生长逐渐转变为平行于界面生长, 且Cu3Sn界面上方的空洞逐渐消失, 空洞形貌趋于扁平. 根据文献[26]可知, 不同温度下Cu原子和Sn原子在Cu3Sn中的原子迁移率相差1~2个数量级; 考虑真实体系中Cu原子和Sn原子迁移率同时受到Cu3Sn, Cu6Sn5和Cu3Sn/Cu6Sn5界面的影响, 后续研究采用的原子迁移率为

图3 Cu/Cu3Sn界面和Cu3Sn层Kirkendall空洞在不同原子迁移率时的组织形貌
Fig.3 Simulated morphologies of Kirkendall voids at the Cu/Cu3Sn interface and in the Cu3Sn layer at mobilities of MCu=1 and MSn=0.05 (a), 0.01 (b) and 0.005 (c)
2.2 IMC层厚度对Kirkendall空洞形貌和生长动力学的影响
图4为Cu3Sn层厚度变化时Kirkendall空洞形貌演化的模拟结果. 模拟初始设置3种Cu3Sn层尺寸范围
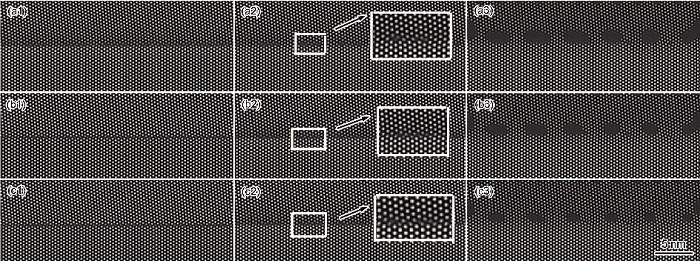
图4 不同Cu3Sn层厚度下Cu/Cu3Sn界面Kirkendall空洞组织形貌
Fig.4 Simulated morphologies of Kirkendall voids at the Cu/Cu3Sn interface with thickness ratios of Cu3Sn layer to Cu layer being 1∶1 (a1~a3), 9∶10 (b1~b3) and 4∶5 (c1~c3) at t=0.6×105 (a1, b1, c1), 1×105 (a2, b2, c2) and 7×105 (a3, b3, c3) (Insets show the corresponding enlarged views)
图5为3种不同Cu3Sn层厚度情况下Kirkendall空洞数量随时效时间(总时效时间t=9.95×105)的变化关系. 显然, Kirkendall空洞的生长动力学行为受Cu3Sn层厚度的影响, 其数量先增加后减少, 呈现明显的阶段性: (1) 初始阶段, Kirkendall空洞的数量随时间有较大增加, 表明此过程中其在Cu/Cu3Sn界面处快速形核并长大; (2) 生长阶段, Kirkendall空洞的数量在该阶段不断减少, 表明其在界面处合并生长; 这些生长特征在图4所示的形貌演化模拟结果中均有反映. 从图5还可明确看到, 受Cu3Sn层厚度影响Kirkendall空洞生长的初始阶段经历的时间有所不同; 例如Cu3Sn层较厚(Cu3Sn与Cu层厚度比Cu3Sn∶Cu=1∶1)时的初始阶段较长(t<8×105), Cu3Sn层较薄(Cu3Sn∶Cu=4∶5)时的初始阶段时间较短(t<6×105). 此外还可见, Cu3Sn层较厚的生长阶段中空洞合并生长较为明显, 数量减少较快(Cu3Sn∶Cu=1∶1); 而Cu3Sn层较薄的生长阶段空洞合并生长较少, 数量变化较慢(Cu3Sn∶Cu=4∶5). 无论Cu3Sn层厚度如何变化, Kirkendall空洞形成长大过程中, 空洞数量均呈现先增后减的规律, 相比于实验观察[13]所发现的空洞数量随Cu3Sn厚度减小而减少的现象, 本研究更全面地揭示了Kirkendall空洞的生长规律.

图5 不同Cu3Sn层厚度时Cu/Cu3Sn界面Kirkendall空洞数量随时间的变化关系
Fig.5 Time dependences of Kirkendall void number at the Cu/Cu3Sn interface with different Cu3Sn layer thicknesses
图6为3种不同Cu3Sn层厚度下Kirkendall空洞尺寸随时间的变化(图中对应的数据分布点)及拟合结果(图中对应的曲线). 由于Kirkendall空洞合并生长而呈不规则形状, 本研究中采用其横向尺寸和纵向尺寸的平均值作为空洞的平均尺寸. 空洞横向尺寸为空洞沿Cu/Cu3Sn界面方向(横向)所占的长度, 纵向尺寸指空洞沿垂直于Cu/Cu3Sn界面方向所占的高度. 为保证统计样本尽量充足并综合考虑计算耗时, 对每种模拟情况均做3次单独的模拟; 3次模拟的初始条件(包括杂质含量、体系大小和时间步长等)均相同, 将3次模拟得到的尺寸再做平均后得出最后用于统计的尺寸. 从图6可见, 随Cu3Sn层厚度的减小, 空洞的尺寸减小; 结合图5结果可得出, 空洞数量和尺寸均随Cu3Sn层厚度的减小而减小, 这一规律与实验研究[12]所获得的结论一致.
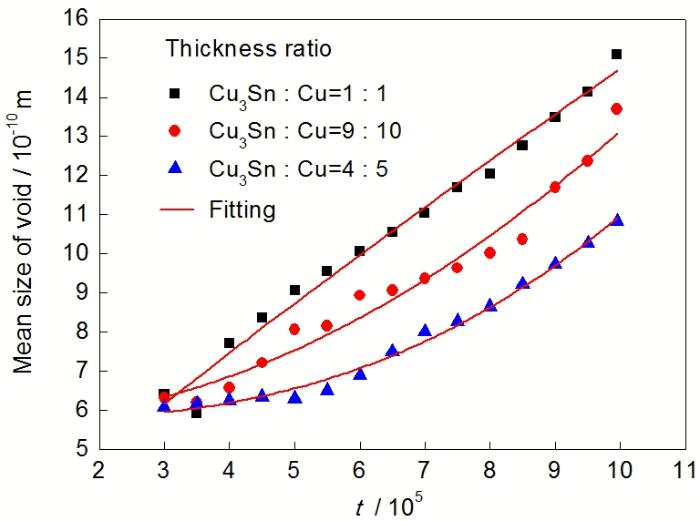
图6 不同Cu3Sn层厚度时Cu/Cu3Sn 界面Kirkendall空洞尺寸随时间变化关系
Fig.6 Time dependences of size of Kirkendall void at the Cu/Cu3Sn interface with different Cu3Sn layer thicknesses
微互连界面Kirkendall空洞与IMC存在很强的关联性, 空洞常出现在Cu/Cu3Sn界面和Cu3Sn层内, 极少出现在Cu6Sn5层, 其尺寸伴随Cu3Sn层的减少而减小. 近年来, 对微焊点中Kirkendall空洞形核和生长做了大量实验研究和理论分析, 得出了界面形核自由能和界面能与应力的关系[28], 并建立了Kirkendall空洞在微焊点中形核生长的本构模型[29], 将空洞生长速率与扩散能联系起来, 对空洞生长进行定量表征. 通过对应力的分析[30]认为, 空洞的生长与空洞表面原子迁移率成正比. 此外研究还表明, 空洞尺寸量化可以用IMC层量化方法进行统计[31], 即采用式(19)所示的指数函数进行描述:
其中, Y表示界面反应t时刻Kirkendall空洞尺寸, nY为空洞生长指数,
通过拟合曲线获得的Kt和nY列于表2. 可知, 随Cu3Sn层厚度减小, nY呈减小趋势. Cu3Sn∶Cu=1∶1时nY=1.126, 而Cu3Sn∶Cu=4∶5时nY=0.312. 由已有研究结论[32]可知, nY处于0.3~1.5时可认为空洞在界面处形核, 即本研究所选取的不同Cu3Sn厚度的情形均可认为在界面处形核. 由此可见, Kirkendall空洞的形核位置与Cu3Sn层厚度无关.
表2 不同Cu3Sn层厚度情况下Cu/Cu3Sn 界面Kirkendall空洞尺寸随时间变化指数拟合结果
Table 2 Exponential fitting results of time dependence of size of Kirkendall void at the Cu/Cu3Sn interface with different Cu3Sn layer thicknesses
| Thickness ratio | Kt | nY | RY2 |
|---|---|---|---|
| Cu3Sn∶Cu=1∶1 | 1.679 | 1.126 | 0.983 |
| Cu3Sn∶Cu=9∶10 | 2.689 | 0.535 | 0.980 |
| Cu3Sn∶Cu=4∶5 | 6.152 | 0.312 | 0.994 |
2.3 杂质含量对Kirkendall空洞形貌和生长动力学的影响
研究[13-15]发现, Cu焊盘电镀层内含有的多种杂质(S, Cl, N和C等)可在焊点形成过程中进入IMC层. 而杂质的存在相当于在Cu3Sn层中引入了异质形核点, 引起Kirkendall空洞的非均匀形核和偏聚以及降低了界面处空洞形成能, 并引发应力局部集中和空位阱的钉扎, 造成空位浓度过饱和, 从而形成Kirkendall空洞. 为了研究不同杂质含量情况下Kirkendall空洞的形貌演化过程, 采用图7所示的模型. 模拟采用二维体系大小为

图7 模拟计算采用的二维区域示意图
图8为模拟Cu3Sn层存在3种不同杂质含量(12.98%, 22.26%和35.56%)时Kirkendall空洞形貌随时效时间(总时效时间t=7×105)演化结果. 可以看出, t从0到1×105的过程中, 界面层两侧的原子不断吞噬界面, 最终在界面处形成原子错配区, 如图8a2, b2和c2所示. 原子错配区数量随杂质含量的增加而增大, 相邻原子错配区之间的间距则随杂质含量增大而减小. 当杂质含量较高时, 演化初期已有大量的原子错配区分布于Cu3Sn层内, 它们在时效过程中起到钉扎作用, 造成空位阱减小, 使得该区域空位浓度过饱和[27], 从而引起空洞生长. 随杂质含量的增加, 原子错配区密度增大, 时效后期形成的空洞数量和尺寸均增大; 同时由于杂质颗粒分布的不确定性, 造成空洞出现位置的不确定性, 在模拟中表现为Cu3Sn层内部和顶端同时出现不规则的Kirkendall空洞. 随时效时间的延长, Kirkendall空洞在界面处形成后不断长大, 其中尺寸较大的空洞在生长过程中与邻近空洞合并; 在演化后期, 空洞之间合并而引起生长加剧, 形成体积较大的空洞; 由图8a3, b3和c3清晰可见, 随杂质含量的增加, 演化后期Kirkendall空洞的数量和尺寸均明显增大.

图8 不同杂质含量时Cu/Cu3Sn界面Kirkendall空洞的组织形貌
Fig.8 Simulated morphologies of Kirkendall voids at the Cu/Cu3Sn interfaces with impurity concentrations of 12.98% (a1~a3), 22.26% (b1~b3) and 35.56% (c1~c3) at t=0.6×105 (a1, b1, c1), 1×105 (a2, b2, c2) and 7×105 (a3, b3, c3) (Insets show the corresponding enlarge views)
图9为Cu3Sn层存在3种不同杂质含量情况下Kirkendall空洞数量随时效时间的变化关系. 显然, 杂质含量对Kirkendall空洞生长动力学有明显影响. 杂质含量为22.26%和35.56%时, Kirkendall空洞的数量随时间变化具有明显的阶段性: (1) 初始阶段, Kirkendall空洞的数量随时间而显著增加, 表明此过程主要是空洞在界面处快速形核长大阶段; (2) 生长阶段, Kirkendall空洞在该阶段数量不断下降, 表明其在界面处合并生长. 值得注意的是杂质含量为12.98%时, Kirkendall空洞生长过程中数量变化较为复杂, 由图9可见在t=4.5×105和t=7×105均出现空洞数量的峰值, 但空洞数量整体变化仍呈现减小的趋势. 为验证这一现象, 对杂质含量分别为5.12%, 8.16%, 11.23%和14.56%时的Kirkendall空洞数量各做了3次模拟统计, 均出现2次空洞数量峰值. 分析认为: 在生长初期, 空洞优先在界面处形核长大, 此时由于Cu3Sn层内杂质含量相对较小, 空洞形核长大所需时间较长; 在Cu3Sn层内部空洞形成之前, 空洞数量的变化主要来源于界面处空洞的形核长大与合并生长, 故造成空洞数量出现第一次先增后减的变化. 随时效时间的延长, Cu3Sn层内部形成空洞数量的增加量大于界面处合并生长过程中的空洞数量的减小量, 从而出现空洞数量的二次增长; 随时效时间的进一步延长, 空洞出现大量合并生长, 空洞数量急剧减小. 无论杂质含量如何变化, Kirkendall空洞形成长大过程中数量的变化均呈现先增后减的规律.

图9 不同杂质含量情况下Kirkendall空洞数量随时效时间的变化关系
Fig.9 Time dependences of Kirkendall void number at the Cu/Cu3Sn interface with different impurity concentrations
图10为Cu3Sn层内存在3种不同杂质含量情况下Kirkendall空洞尺寸随时间变化(图中对应的数据分布点)及拟合结果(图中对应的曲线). 显然, 整个演化过程中Kirkendall空洞尺寸在不断增加, 但杂质含量为12.98%时尺寸增长率较慢, 而杂质含量为22.26%和35.56%时尺寸增长率较大; 表明不同的杂质含量不仅影响尺寸的大小, 对尺寸增长速率也有影响. 同时还发现, Kirkendall空洞尺寸随杂质含量的增加而增大, 与实验中观察到的镀层中杂质存在可促进空位形核[13-15]的结论相一致, 但无论在何种杂质含量下, Kirkendall空洞的尺寸均随时效时间的延长而增大.

图10 不同杂质含量情况下Kirkendall空洞尺寸与时效时间的变化关系
Fig.10 Time dependences of Kirkendall void size at the Cu/Cu3Sn interface with different impurity concentrations
通过曲线拟合获得的Kt和nY列于表3. 可知, nY随杂质含量的增加呈递增规律, 数值处于0.385和0.899之间. 由研究[32]可知, nY处于0.3~1.5时可认为空洞在界面处形核, 故本研究所选取的不同杂质含量情形下Kirkendall空洞均可认为在界面处形核, 即形核位置与杂质含量无明显关系.
表3 不同杂质含量下Kirkendall空洞尺寸随时间变化的指数拟合结果
Table 3 Exponential fitting results of time dependence of Kirkendall void size at the Cu/Cu3Sn interface with different impurity concentrations
| Impurity concentration | Kt | nY | RY2 |
|---|---|---|---|
| 12.98% | 0.0270 | 0.385 | 0.989 |
| 22.26% | 0.2050 | 0.556 | 0.990 |
| 35.56% | 0.5362 | 0.899 | 0.992 |
3 结论
(1) Kirkendall空洞优先在Cu/Cu3Sn界面处形成和长大. 时效初期Cu/Cu3Sn界面处快速生成原子错配区, 进而演化为Kirkendall空洞; 时效中期Cu/Cu3Sn界面处空洞尺寸和生长速率较大, 空洞间合并生长明显; Cu3Sn层内空洞尺寸和生长速率较小, 空洞间合并生长不明显; 时效后期Cu/Cu3Sn界面和Cu3Sn层内空洞间距减小并出现合并生长, 导致空洞尺寸增大而数量减小.
(2) Kirkendall空洞数量和尺寸随Cu3Sn层厚度的增大而增加, 其生长指数随Cu3Sn层厚度的减小而减小; Cu3Sn层厚度并不明显影响Kirkendall空洞的形核位置和生长规律, 空洞数量随时间呈现先增后减的变化规律.
(3) Kirkendall空洞的数量、尺寸和尺寸增长速率均随杂质含量的增加而增大, 其生长指数也随杂质含量的增加而增大. 在整个时效过程中, 杂质含量对Kirkendall空洞形核位置和生长规律的影响并不明显, Kirkendall空洞数量随时间呈现先增后减的变化规律
来源---金属学报






 沪公网安备31011202020290号
沪公网安备31011202020290号
